-
磁阻式存储器(Magneto-resistive Random-Access Memory, MRAM)作为第三代非易失存储技术的代表,具有与SRAM相媲美的读写速度、低于EEPROM器件几个数量级的写入功耗、无限次数的擦写可靠性等特点,使得MRAM成为通用型存储器的备选,在航天微电子系统中具有广阔的应用前景[1-2]。传统型非易失性存储器,如Flash、EEPROM等属于电荷捕获型存储器,因而对空间环境中的高能粒子辐照损伤比较敏感,所以无法胜任长期在轨与深空探测任务中的抗辐射能力等级的要求[1]。MRAM存储器的存储结构不同于传统的浮栅型存储结构,而是创新性地采用了两层铁磁薄膜中间夹着几纳米厚的绝缘势垒层组成的多层薄膜堆叠结构,利用两层铁磁薄膜自旋极化方向的平行与反平行状态下具有不同的电阻值,从而实现存储二进制比特信息的能力[3],因此MRAM器件的抗电离辐射能力优于传统的浮栅型非易失存储器。
开展加速器重离子辐照MRAM器件模拟实验,研究其在辐射环境下工作的可靠性及其宏观电学功能失效的内在机理,对MRAM器件的在轨应用及抗辐射加固设计都具有十分重要的意义。国外开展MRAM器件的辐照失效机理研究始于本世纪初,主要分为两个方向:其一是针对磁性隧道结(Magnetic Tunnel Junction, MTJ)多层薄膜堆叠结构开展了质子、中子、伽马及重离子辐照实验,研究辐照损伤对MTJ电学和磁学性能的影响。Ren等[4]和Kobayashi等[5]等的实验结果表明,重离子辐照后MTJ的电学与磁学性质都没有出现统计性的退化。然而 Conraux等[6]的研究表明,重离子辐照MTJ后其电学性能出现了不可恢复的退化,证明MTJ结构并不能免疫重离子的辐照损伤。另外,在MRAM器件的辐照效应研究方面,文献[7-9]表明,高能粒子辐照环境下MRAM器件的主要可靠性问题是发生在前道CMOS工艺电路中的SEL与SEFI效应,而存储阵列免疫于高能粒子的辐照损伤。但是文献[10-11]的实验结果显示,MRAM器件存储阵列的MTJ在伽马射线辐照下会发生读取错误。这些研究结果表明MRAM器件的辐照损伤机理还不清晰,微观辐照损伤导致MTJ宏观电学功能退化的物理规律还有待建立。因此系统研究重离子辐照下存储阵列中MTJ电学功能失效的物理规律,不仅有助于澄清MRAM器件在重离子辐照下的失效机理,而且还有助于发展新型非易失存储器的辐照测试技术。
基于以上原因,为了精准分析存储阵列中的MTJ在高能重离子辐照下的损伤机理,本文针对MRAM器件的非易失性特性设计了Non-volatile测试模式,并在兰州重离子研究装置(HIRFL)上开展了重离子辐照实验。首先,将详细地介绍MTJ的物理机制、MRAM芯片的信息和高能重离子辐照实验参数及辐照测试流程。其次,将分析讨论试验中观察到的硬错误类型、累积离子注量对硬错误的影响和MTJ不同电阻态失效类型的物理特性。最后通过理论计算、对照试验和仿真模拟讨论分析硬错误产生的物理机制。
-
两层铁磁薄膜中间夹上纳米级厚度的金属氧化物绝缘薄膜形成的多层薄膜堆叠结构即:磁性隧道结(MTJ)。MTJ结构中的不导电绝缘体成为阻挡电子流通的‘墙壁’,但是电子能通过量子隧穿效应穿过绝缘薄膜,即隧穿磁阻效应(Tunnel Magnetoresistance, TM)[12]。如图1所示,实验测到该结构的电阻值随着绝缘层两侧铁磁层相对磁化方向的改变而变化很大,因此能形成电阻差异较明显的两种物理稳态,进而可实现二进制数据‘0’与‘1’的存储。能带理论认为过渡金属材料的磁性是由于3d与4s带交叠在一起,3d电子虽然存在能带结构,但它们又相当局域,电子间的交换使自旋简并的电子能带发生分裂。考虑电子间的交换作用后,能带分裂成不对称形式,其中上自旋电子比下自旋电子数目多,在3d能带形成未被抵消的自发磁矩。经典物理将导体中电子受到晶格原子的散射被定义为电阻,而巨磁阻效应是由于磁性材料对具有不同自旋取向的电子散射率不同而导致的结果[13]。
-
实验选用的磁阻式存储器为Freescale公司生产的全球第一款商用MRAM[14]:MR2A16A是一款4 Mbit的3.3 V异步存储器,读写周期35 ns。存储基本单元为一个NMOS晶体管、一个磁性隧道结的组成的1T1MTJ结构,存储单元面积为1.3
$ {\text{μm}}^2 $ 。MR2A16A的存储结构与顶部光学图像如图2所示。为了保证离子在芯片中有足够的射程到达敏感区,因此在进行辐照之前需要对芯片开封处理。使用开封机对芯片进行开封处理之后,再经过化学试剂侵泡处理将芯片钝化层上130 μm 厚的坡莫合金取下,芯片功能测试正常之后才能用于辐照试验。
-
利用HIRFL开展重离子辐照实验。如图3所示,在Non-volatile测试模式下,外围电路处于非工作不加电状态,因此可以排除其对存储阵列的影响,进而可以研究存储阵列磁性隧道结对辐射损伤的敏感性。Non-volatile模式在真空实验罐中进行,通过在测试芯片表面加不同厚度的铝箔得到能量不同的离子,试验中的离子注量为1×107 ions/cm2·s。
使用蒙特卡罗模拟程序(SRIM)计算重离子辐照参数[15],具体的参数如表1所列。由于MTJ位于芯片表面下5.6 µm处,因此所有的离子均能够到达MTJ层。
表 1 辐照实验所用的重离子参数
离子种类 铝箔/μm 芯片表面能量/(MeV/u) 硅中LET/(MeV·cm2/mg) 硅中射程/μm 数据图形 离子注量/(ions/cm2) Ta 24 10.9 75.7 115.4 55h/FFh 1×108 1×109 3×1010 1×1011 -
通过高能Ta离子辐照实验,我们观察到了由重离子辐照损伤引起MTJ功能失效的硬错误(Hard Bit Error)现象。本文中定义的硬错误是两种失效类型的总称:存储阵列错误数不随着写入相同数据次数的增加而减少的稳定型硬错误,以及存储阵列错误数会随着写入相同数据次数的增加而减少的不稳定型硬错误。
第一类硬错误:在可预期的测试时间内(几天),存储阵列中的硬错误数不会随着全地址写入相同数据次数的增加而改变,此类型硬错误属于稳定型硬错误。
第二类硬错误:随着全地址写入相同数据次数的增加,错误数会逐渐减小并达到一个最小数值。若随后没有对存储阵列进行其它任何写入操作,错误数将维持在一个相对稳定值,且不会自动恢复到第一次读取统计到的错误数。但如果对全地址写入互补图形数据时,存储阵列中的硬错误数将恢复到第一次读取统计到的数。因此对全地址依次写入互补图形数据时,总的错误数不会出现统计性的变化。
-
图4为Ta离子辐照实验结果。其中图4(a)为硬错误数随单位MTJ累积辐照离子数增加的实验结果,可以得到硬错误数会随着辐照离子数的增加而上升,表现出了明显的注量依赖效应。值得注意的是,当累积注量达到1×108 ions/cm2时(单个MTJ面积为1.3
$ {\text{μm}}^2 $ ),即每个存储单元平均被1.3个Ta离子辐照条件下,实验没有观察到硬错误的出现。因此,一个10.9 MeV/u的Ta离子辐照MTJ引入的损伤不足以造成MTJ的宏观电学功能失效,实验结果表明,Ta离子多次轰击同一个MTJ引入的损伤累积是导致其电学功能失效的关键因素。图4(b)为硬错误截面随单位MTJ累积辐照离子数增加的变化趋势,可以观察到硬错误截面随着离子注量的增加而明显下降,最大下降幅度高达一个数量级。实验结果表明,击中同一个MTJ单元的不同Ta离子引入的损伤对于硬错误出现的贡献比例是不一样的,因此单个MTJ单元累积辐照的Ta离子数不是硬错误出现的一个直接相关参量。MTJ功能硬错误的出现与Ta离子在MTJ单元中引入损伤的分布、精细结构和损伤之间的协同作用等参量直接相关,因此即使每个MTJ单元的平均累积辐照离子数一样,但是Ta离子在不同MTJ单元内引入的损伤分布等硬错误产生的直接参量是不同的。我们的实验结果同时表明,当我们在地面开展重离子辐照考核的失效错误截面与离子的注量具有负比例系数时,应结合器件的工作环境辐射通量情况选择合适的离子注量进行辐照加速测试,以避免辐照注量过大而高估器件的抗辐射性能。 -
图5为在1×109 ions/cm2注量下的实验结果。图5(a)为对第一次回读后记录的硬错误进行的统计分析,实验发现了三种失效模式:高电阻态失效(1 → 0)、低电阻态失效(0 → 1)以及高低电阻态的同时失效模式(1 ↔ 0)。其中高电阻态失效模式占总硬错误的比例为79.9%,是决定MTJ在辐射环境下工作可靠性的关键失效模式。从图5(b)我们发现,随着对存储阵列全地址写入相同数据图形次数的增加,目标数据图形的写入成功率逐渐升高并最终达到一个最大值(<100%),但是当我们交替写入互补图形数据时,存储阵列的错误数不会随着写入次数的增加而改变。因此,该类型错误不同于上面提到的第一种硬错误(存储阵列错误数不会随着写入次数的增加而改变)类型,我们将其命名为不稳定型硬错误失效模式。因此对存储阵列全地址重复写入相同图形的测试数据可以使写入成功率提高,但是重离子辐照在MTJ中引起的损伤并没有被修复,所以当我们写入互补图形数据时(铁磁薄膜的自旋极化状态需要改变),重离子引入的潜在损伤便被再次观察到了。
-
从物理图像上出发,利用Slonczewski模型计算MTJ结构的电阻值[16]:磁隧道结的电导可表示为下列公式:
$$G\left( \theta \right){\rm{ = }}{G_0}\left( {1 + P_1'P_2'{\rm{cos}} \theta } \right),$$ (1) 式中:
${G_0}$ 为当不考虑两侧铁磁层自旋散射机制时磁隧道结的电导率;$\theta $ 为两铁磁层磁化方向的夹角;$P_1'$ 和$P_2'$ 为两侧铁磁层的有效自旋极化率,表示为$$P_n' = \frac{{{k_{ \uparrow n}} - {k_{ \downarrow n}}}}{{{k_{ \uparrow n}} + {k_{ \downarrow n}}}} \times \frac{{{\kappa ^2} - {k_{ \uparrow n}}{k_{ \downarrow n}}}}{{{\kappa ^2} + {k_{ \uparrow n}}{k_{ \downarrow n}}}} = {P_n} \times {A_n},~n = 1,2;$$ (2) 式中:
${k_{ \uparrow n}}$ 和${k_{ \downarrow n}}$ 分别为上自旋和下自旋电子的 Fermi 波矢;$\kappa $ 为绝缘层势垒内的波函数衰减系数,与势垒高度$\phi $ 相关:$$\phi = U{}_0\left( {x > 0} \right) - {E_{\rm{F}}} = {{{\kappa ^2}}/2},$$ (3) 式中:
$U{}_0\left( {x > 0} \right)$ 为表面势能;${E_{\rm{F}}}$ 为费米能。结合式(2)和式(3)代入式(1),可推导$$\Delta G{\rm{ = }}{G_{ \downarrow \uparrow }} - {G_{ \downarrow \downarrow }} = 2{G_0}P_1'P_2',$$ (4) 式中:
$\Delta G$ 表示两侧铁磁层磁化方向在平行与反平行状态下,磁隧道结电导率的差异。将式(1)与式(4)代入磁阻变化率MR公式中,可推导$$\begin{split}MR =& \left( {\frac{{{R_{ \downarrow \uparrow }} - {R_{ \downarrow \downarrow }}}}{{{R_{ \downarrow \downarrow }}}}} \right) \times 100{\text{%}} = \left( {\frac{{G_{ \downarrow \uparrow }^{ - 1} - G_{ \downarrow \downarrow }^{ - 1}}}{{G_{ \downarrow \downarrow }^{ - 1}}}} \right) \times100{\text{%}}\\ =& \left( {\frac{{2P_1'P_2'}}{{1 - P_1'P_2'}}} \right) \times 100{\text{%}} \text{,}\\[-14pt] \end{split}$$ (5) 式中:
$P_1'$ 和$P_2'$ 为两侧铁磁层的有效自旋极化率。由推算结果可以得出,MR值的大小与绝缘层的势垒高度
$ \phi $ 密切相关。由式(5)可知,MRAM存储稳定性的衡量参数MR与绝缘势垒的高度值是幂指数关系,因此较小的势垒下降会引起较大的MR值下降。重离子穿透 MTJ 时会沉积能量电离产生电子空穴对,电子空穴复合会释放大量的能量并对MTJ结构产生损伤。使得绝缘层的势垒高度$ \phi $ 降低,进而势垒内的波函数衰减系数$ \kappa $ 降低,铁磁层的有效自发极化率$ {P}_{n}' $ 下降,最终导致MR值变小。若绝缘势垒层的损伤积累超过一定阈值,会使MTJ结构的自旋反平行态的高电阻值变小,进而失去了存储二进制数据“1”的能力,即造成高电阻态失效模式。其次,电子在铁磁金属薄膜中输运的电阻率有三个来源,如式(6)所示:
$$\rho {\rm{(}}T{\rm{) = }}{\rho ^{}_{\rm{d}}} + {\rho^{} _{\rm{L}}}(T) + {\rho ^{}_{\rm{M}}}(T),$$ (6) 其中
$ {\rho}^{}_{\text{d}} $ 为杂质或者缺陷散射引起的剩余电阻率;$ {\rho}^{}_{\text{L }} $ 为晶格声子对电子的散射;$ {\rho}^{}_{\text{M}} $ 是与磁化有序度相关的散射所导致的电阻率。当重离子辐照铁磁薄膜时,会在其中引入缺陷造成磁畴的局部无序态,从而会造成铁磁金属的电阻率升高。若铁磁薄膜的损伤积累超过阈值,会使MTJ结构自旋平行态的小电阻值变大,进而失去存储二进制数据“0”的能力,即引起低电阻态失效模式。辐射损伤造成的磁畴局部无序引起的电阻态失效,可通过施加多次激励磁场来提高铁磁薄膜的极化有序度,因此实验中观察到硬错误数会随着全地址写入次数的增加而下降。但重离子造成的损伤并没有被预设激励磁场所修复,当写入相反数据图形时(铁磁薄膜的极化状态需要翻转),这种不稳定的硬错误便被再次观察到。图6为使用TRIM程序模拟的Ta穿透MTJ结构时对各层薄膜造成的损伤分布以及界面原子混合情况。根据图6(a)所示模拟结果,我们可以计算得到当累积辐照离子注量达1×109 ions/cm2时,绝缘势垒层的每原子位移损伤大约为
$ 3\times {10}^{-8} $ 左右。基于图6(b)结果我们可以计算出,相同累计注量下铁磁薄膜层的每原子位移损伤约为$ 6\times {10}^{-8} $ 左右。实验结果显示,MTJ功能失效类型中的79.9%为绝缘势垒层损伤导致的高电阻态失效模式,因此铁磁薄膜的损伤阈值较绝缘势垒层的损伤阈值高,因此提高MTJ结构中的绝缘势垒的抗辐射性能是MRAM抗辐射加固设计的重点。此外,我们在相同的辐照偏置条件下进行了γ总剂量试验。实验结果表明,即使最大累积电离剂量高达16 Mrad(Si),也没有观察到MTJ的宏观电学功能发生失效的现象,因此电离损伤不是硬错误出现的关键因素。综合实验数据、理论分析和模拟计算结果,可以得到MTJ结构的电学性能失效是由于纳米级薄膜材料的结构与物理性能发生了改变或退化,并且位移损伤在MTJ电学功能失效中起到了重要的作用。
-
我们利用兰州重离子加速器提供的初始单核能10.9 MeV/u Ta离子,进行了180 nm Bulk Silicon工艺1T-1MTJ存储结构的MRAM辐照损伤效应研究,系统地研究了高能重离子辐照在MTJ结构中的绝缘势垒层、自旋极化层和两者界面造成的微观损伤累积对MTJ宏观电学性能退化的影响规律。首次在实验中观察到重离子辐照导致MRAM器件存储阵列中MTJ结构损伤引起的硬错误。实验统计结果显示,决定MTJ在辐射环境下工作可靠性的为高电阻态失效(占总失效比例为79.9%)。另外还证实了单个Ta离子辐照损伤无法导致MTJ的宏观电学功能失效,即产生硬错误。计算分析认为,重离子对绝缘势垒层的损伤是高电阻态失效的主要原因,而铁磁薄膜层的辐照损伤引起的缺陷以及磁畴局部无序是引起低电阻态失效的主要原因。本研究的成果为MRAM核心功能元件MTJ的抗辐照加固技术发展提供了关键的数据与模型支撑。
Investigation of Types and Mechanisms of MTJ Function Failure Induced by Heavy Ion Irradiation
-
摘要: 重点研究了磁性隧道结(MTJ)的电学性能受离子注量影响的物理规律。实验首次发现了高能Ta离子辐射损伤导致MTJ电学功能失效的现象,主要失效模式为:高、低电阻态失效,其中79.9%的功能失效为高电阻态失效。计算表明,单个10.9 MeV/u的Ta离子辐照引入的损伤无法导致MTJ宏观电学功能失效。结合理论计算与Monte Carlo模拟分析,MTJ中的绝缘势垒层与铁磁薄膜的损伤是出现高、低电阻态失效的内因。Abstract: We study the physical law of the influence of ion fluence on the electrical properties of magnetic tunnel junctions (MTJ). We find for the first time that high-energy ionization radiation damage caused the failure of MTJ electrical functions in our experiment. The main failure modes are high and low resistance state failures, of which 79.9% are high resistance state failures. Our results show that the damage caused by a single Ta ion with 10.9 MeV/u cannot cause the electrical function of MTJ to fail. Combining theoretical calculations and Monte Carlo simulation analysis, we derive that the damage to the tunnel insulating layer and the ferromagnetic film in the MTJ is the internal cause of high and low resistance state failure.
-
表 1 辐照实验所用的重离子参数
离子种类 铝箔/μm 芯片表面能量/(MeV/u) 硅中LET/(MeV·cm2/mg) 硅中射程/μm 数据图形 离子注量/(ions/cm2) Ta 24 10.9 75.7 115.4 55h/FFh 1×108 1×109 3×1010 1×1011 -
[1] GERARDIN S, PACCAGNELLA A. IEEE Transactions on Nuclear Science, 2010, 57(6): 3016. doi: 10.1109/Tns.2010.2084101 [2] APALKOV D, DIENY B, SLAUGHTER J M. Proceedings of the IEEE, 2016, 104(10): 1796. doi: 10.1109/Jproc.2016.2590142 [3] TEHRANI S, SLAUGHTER J M, DEHERRERA M, et al. Proceedings of the IEEE, 2003, 91(5): 703. doi: 10.1109/Jproc.2003.811804 [4] REN F H, JANDER A, DHAGAT P, et al. IEEE Transactions on Nuclear Science, 2012, 59(6): 3034. doi: 10.1109/Tns.2012.2224375 [5] KOBAYASHI D, KAKEHASHI Y, HIROSE K, et al. IEEE Transactions on Nuclear Science, 2014, 61(4): 1710. doi: 10.1109/Tns.2014.2304738 [6] CONRAUX Y, NOZIERES J P, DA COSTA V, et al. Journal of Applied Physics, 2003, 93(10): 7301. doi: 10.1063/1.1558659 [7] NGUYEN D N, IROM F. Radiation Effects on MRAM[C]// Proceedings of the 9th European Conference on Radiation and Its Effects on Components and Systems. New York: IEEE, 2007: 1. [8] ADELL P C, MORO S, GOUYET L, et al. IEEE Radiation Effects Data Workshop, 2017, 178: 465. doi: 10.1109/NSREC.2017.8115456 [9] HAFER C, VON THUN M, MUNDIE M, et al. IEEE Radiation Effects Data Workshop, 2012, 25: 56. doi: 10.1109/REDW.2012.6353717 [10] CUI Y, YANG L, GAO T, et al. Chinese Physics B, 2017, 26(8): 501. doi: 10.1088/1674-1056/26/8/087501 [11] ZHANG H, BI J, WANG H, et al. Microelectronics Reliability, 2016, 67: 104. doi: 10.1016/j.microrel.2016.10.013 [12] MIYAZAKI T, TEZUKA N. Journal of Magnetism and Magnetic Materials, 1995, 139(3): L231. doi: 10.1016/0304-8853(95)90001-2 [13] FERT A, CAMPBELL I A. Physical Review Letters, 1968, 21(16): 1190. doi: 10.1103/PhysRevLett.21.1190 [14] ENGEL B N, AKERMAN J, BUTCHER B, et al. IEEE Transactions on Magnetics, 2005, 41(1): 132. doi: 10.1109/Tmag.2004.840847 [15] ZIEGLER J F, ZIEGLER M D, BIERSACK J P. Nucl Instr and Meth B, 2010, 268(11): 1818. doi: 10.1016/j.nimb.2010.02.091 [16] SLONCZEWSKI J C. Journal of Magnetism and Magnetic Materials, 1996, 159(1-2): L1. doi: 10.1016/0304-8853(96)00062-5 -





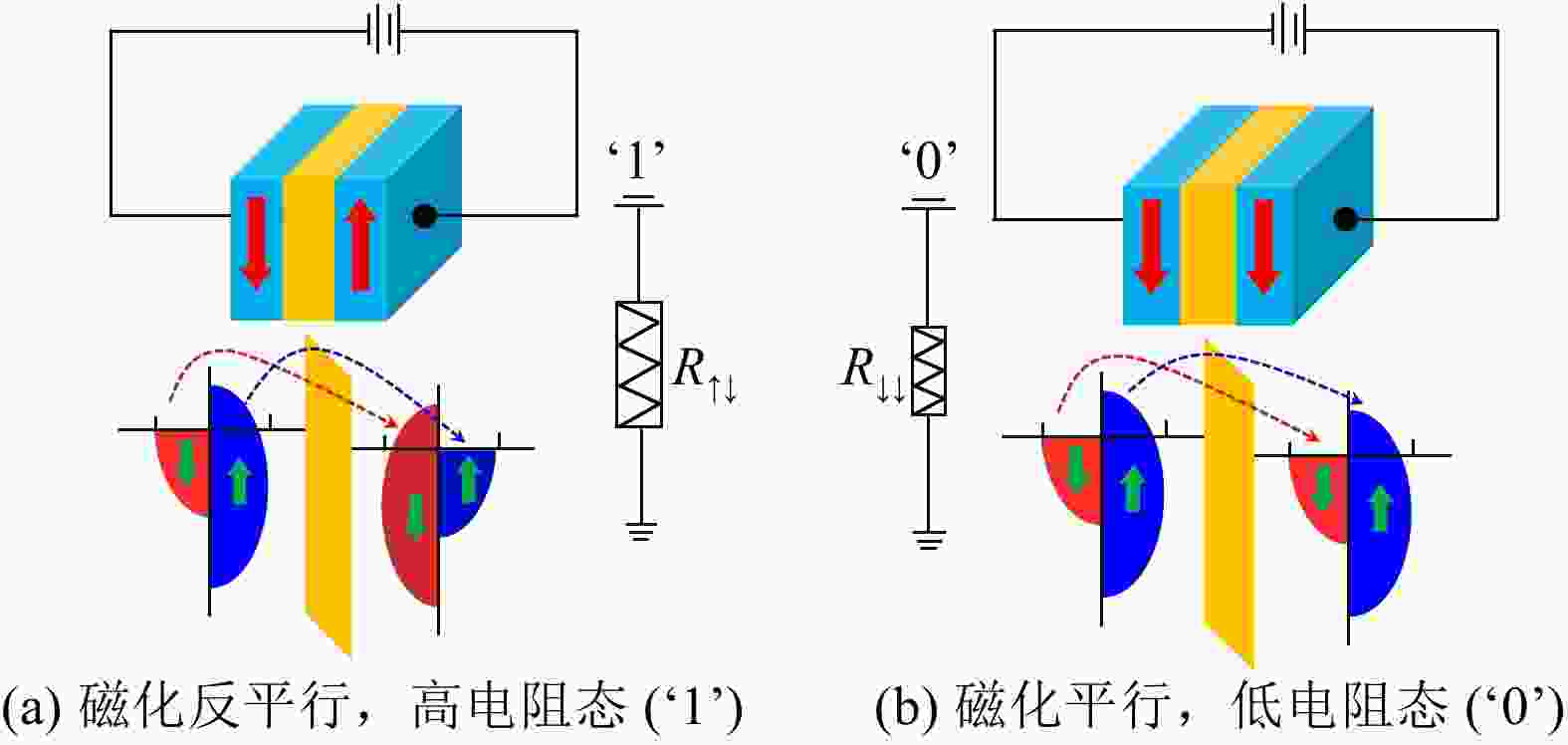
 下载:
下载:
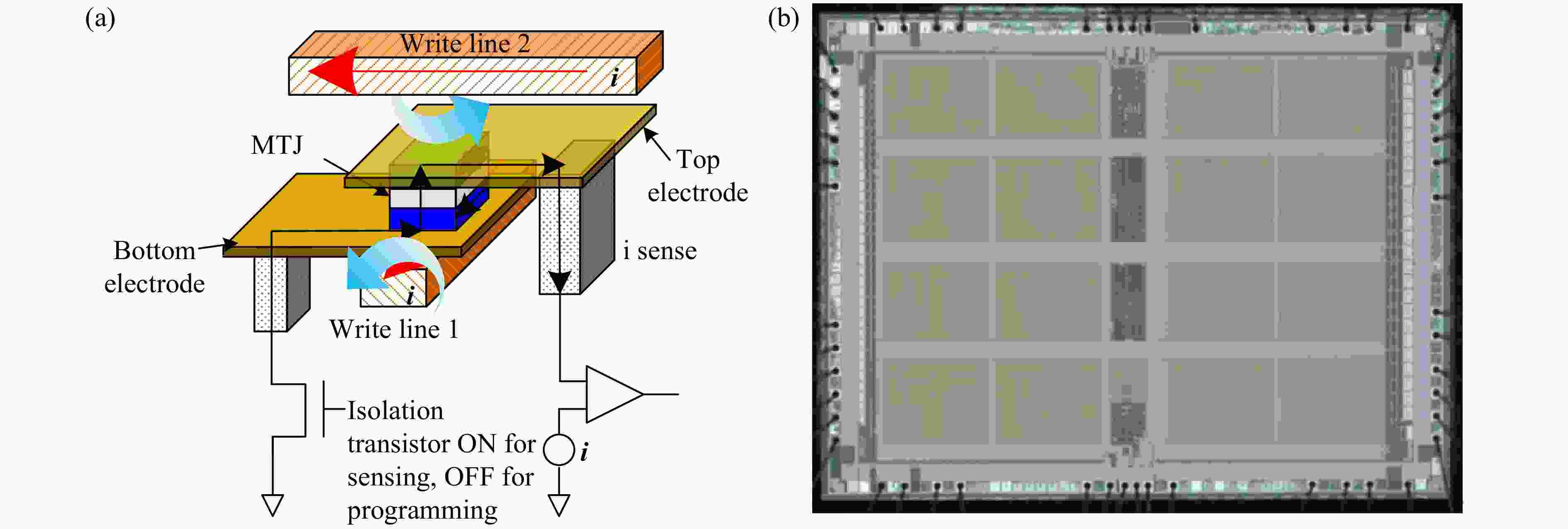
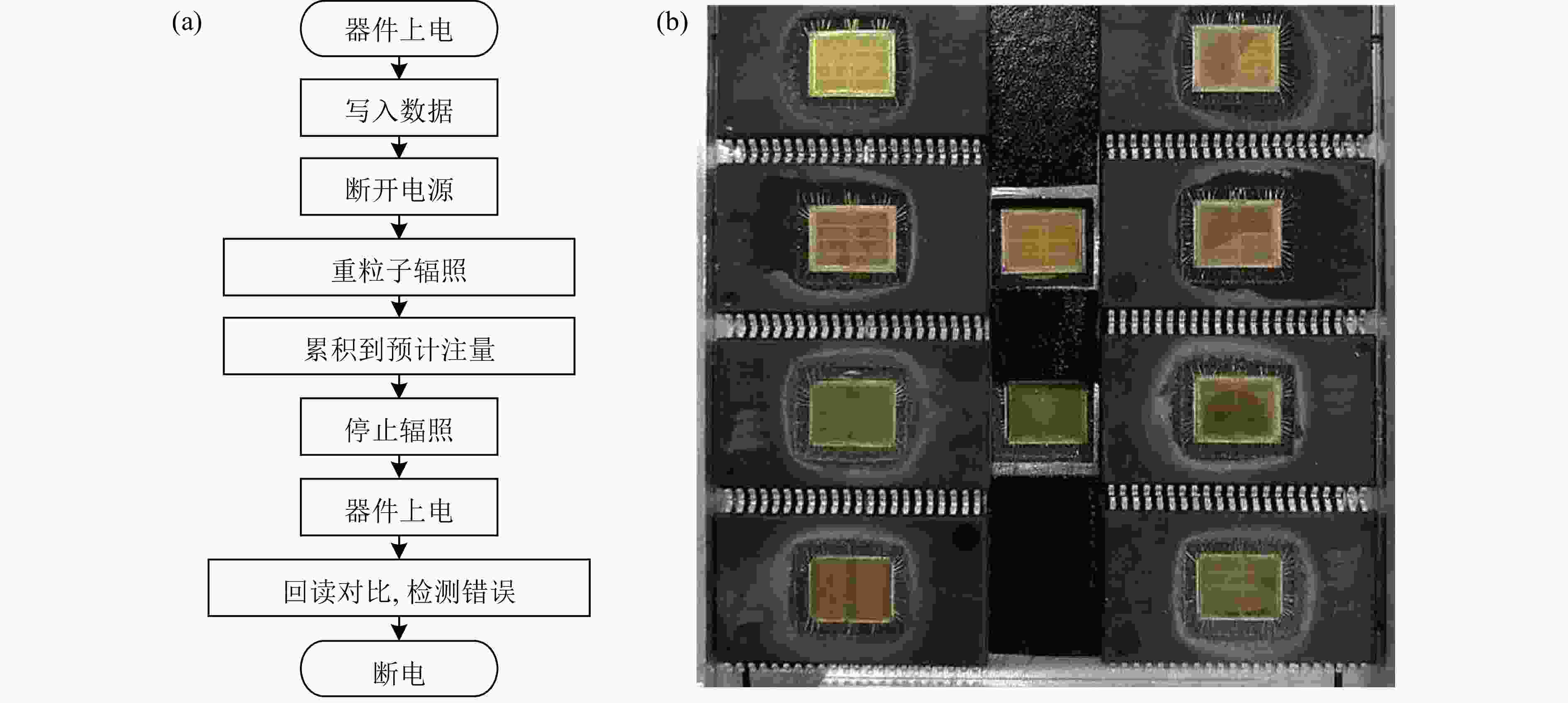
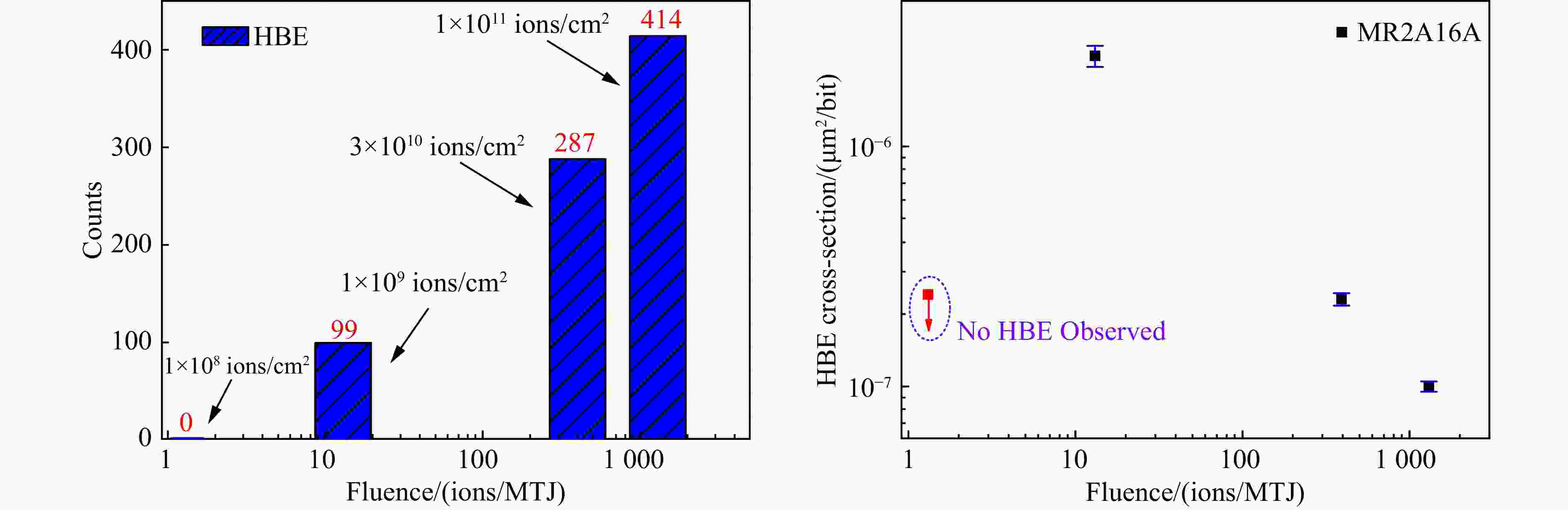
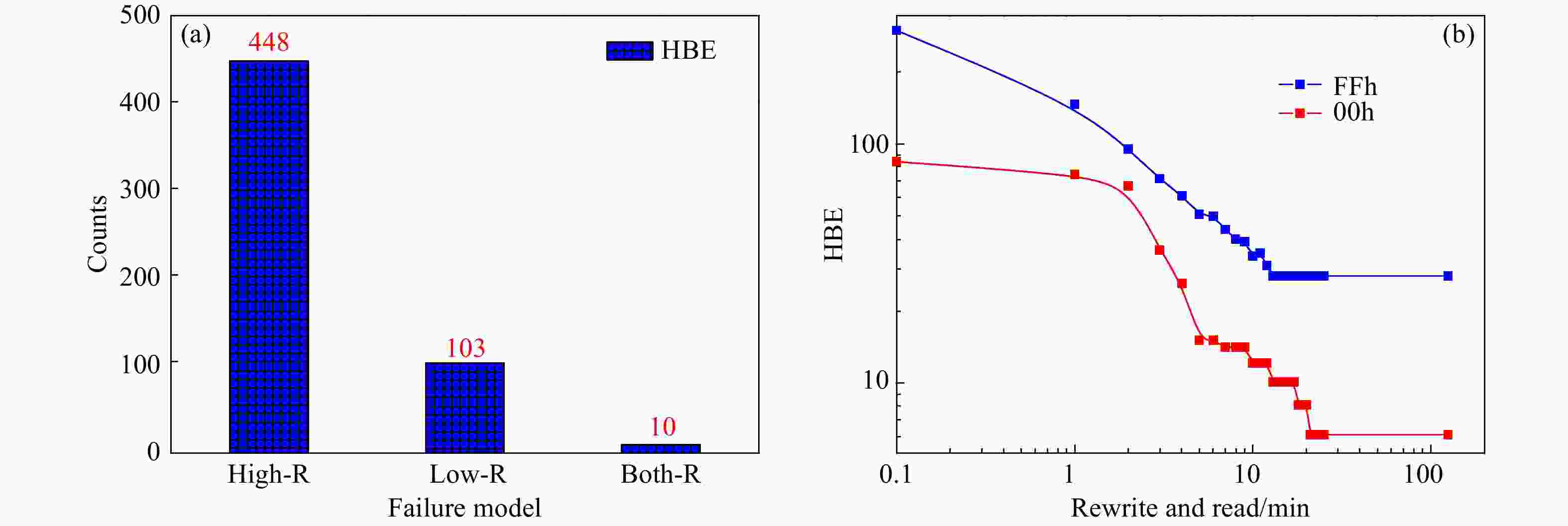


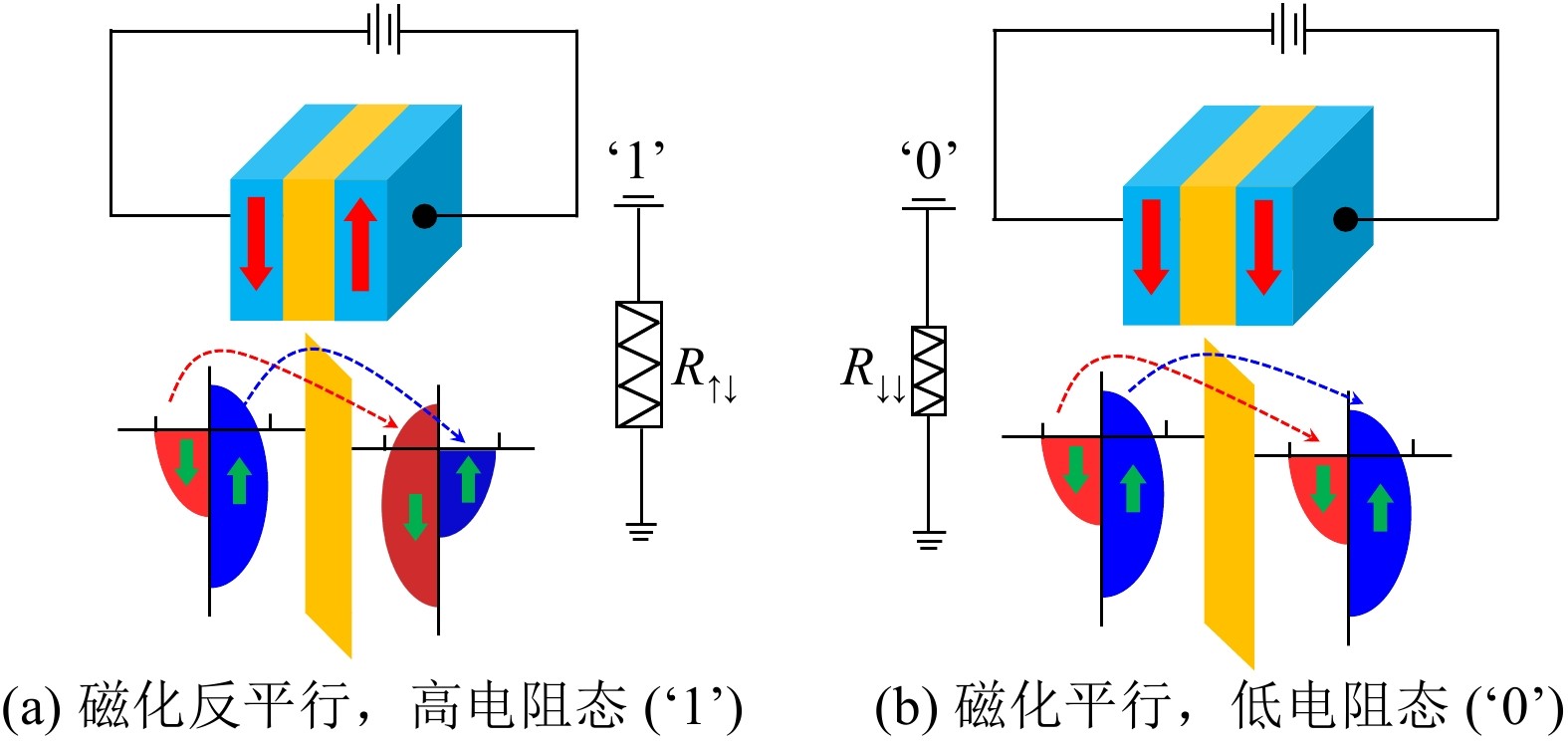






























 甘公网安备 62010202000723号
甘公网安备 62010202000723号